Elektronik 311 MOSFETProf. Dr. J÷rg Vollrath10 MOSFET |
Video 11 MOSEFT
|
Lõnge: 01:06:27 |
0:0:0 R³ckblick und Heute 0:1:18 MOSFET als Schalter 0:5:6 Arbeitsbereich Linearbereich 0:7:45 RDSon 0:13:20 ALD1116 Datenblatt 0:16:39 Features 0:19:20 Absolute maximum ratings 0:20:10 Vt 0:23:16 GIS gm mho=S 0:25:30 ▄bertragungskennlinie und Ausgangskennlinie 0:30:32 KP = KN = 2 β 0:32:36 λ 0:34:40 CIS = Cox 0:37:28 P Kanal MOSFET Mikroskopbild 0:41:0 PFET auf dem Breadboard 0:43:30 Messschaltung 0:44:42 Datenblatt Kennlinien 0:46:48 Transistorgehõuse und Anschl³sse 0:47:22 Messaufbau 0:49:53 Arbitrary waveform generator AWG Funktionsgenerator 0:51:37 Oszilloskopbild 0:53:15 Mathematikkanal definieren. 0:53:43 xy Darstellung 0:57:10 Ausgangskennlinie 0:58:12 MOSFET Parameterextraktion 1:2:17 Trendlinie und Messung y = IDS x = UGS 1:5:30 JFET low noise, wenig Rauschen 1:10:42 Leistungs-MOSFET Drain unten |
R³ckblick und Heute
- MOSFET:
- MOSFET als Verstõrker: Spannungsverstõrkung, Frequenzgang
- MOSFET als Schalter: Ausgangswiderstand
- MOSFET Datenblatt
- MOSFET Messung
- JFET
- Leistungs-MOSFET
Elektronische Schaltungstechnik, Reinhold: Kapitel 4, S. 65-95
Microelectronic, Jaeger: Chapter 5, page: 217-284
MOSFET als Schalter
|
MOSFET als Schalter
Ron \( I_{DS} = \beta \left( 2 \left(U_{GS}-U_{th}\right)U_{DS}-U_{DS}^2\right) \) \( R_{on} = R_{DS} = \left[\frac{dI_{DS}}{dU_{DS}}\right]^{-1} = \frac{1}{\beta 2 \left(U_{GS}-U_{th}-U_{DS}\right)} \) F³r kleine UDS gilt:
|
MOSFET Model Parameter
NMOS Transistor ALD-1116: F³r einen Strom IDS=10mA finden Sie die Werte f³r VthN, KP, \( \lambda \), CGS und CGD aus dem Datenblatt.
Google Suche: NMOS Transistor ALD-1116
www.aldinc.com/pdf/ALD1106.pdf
Lokale Kopie
www.aldinc.com/pdf/ALD1106.pdf
Lokale Kopie
|
T=25░C, VDS= 5 V VthN = 0.7 V IDS= 4.8 mA GIS= 1.8 mS = g_m GOS= 200 uS = g_d CISS=1 pF |
\( \lambda = \frac{g_d}{I_{DS}} = \frac{G_{OS}}{I_{DS}}
= \frac{0.2 mS}{10 mA} = 0.02 V^{-1} \) \( K_N \) vom on drain current \( I_{DS(ON)} \): \( K_N = \frac{2 \cdot I_{DS(ON)}}{\left( U_{GS} - U_{th}\right)^{2}} \) \( K_N = \frac{2 \cdot 4.8 mA }{\left( 5 V - 0.7 V \right)^{2}} = 0.5 \frac{mA}{V^{2}} \) \( C_{ISS} = C_{GS} + C_{GD} \rightarrow C_{GS} = 1 pF; \) \( g_m = 1.8 mS; f_t = \frac{g_m}{2 \pi C_{ISS}} = 300 MHz,v_u = -\frac{G_{IS}}{G_{OS}} = -9 \) |
P-Channel Enhancement-Mode MOSFET Transistors
| Part Number | \( V(BR)_{DSS} \) Min (V) | \( V_{GS}(th) \) (V) | \( r_{DS}(on) \) Max \( (\Omega) \) | \( I_D(on) \) Min (mA) | \( C_{rss} \) Max(pF) | \( t_{ON} \) Typ(ns) |
| 3N163 | -40 | -2 to -5 | 250 | -5 | 0.7 | 18 |
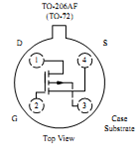
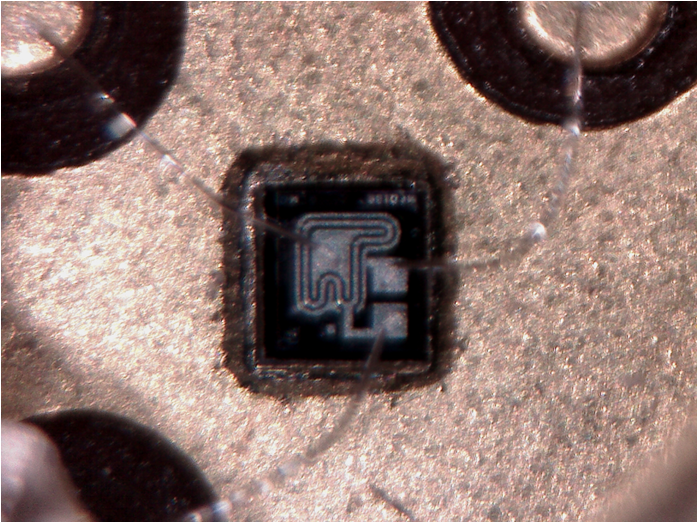

Quelle Datenblatt Quelle Vollrath
P-Channel Enhancement-Mode MOSFET Transistors 3N163
|
Quelle Datenblatt Siliconix 3N163 |
Messaufbau 3N163
Source: GND, Drain: 100 Ω, AWG1, AWG2, Gate: AWG2, AWG1
|

|
Messung 3N163
 |
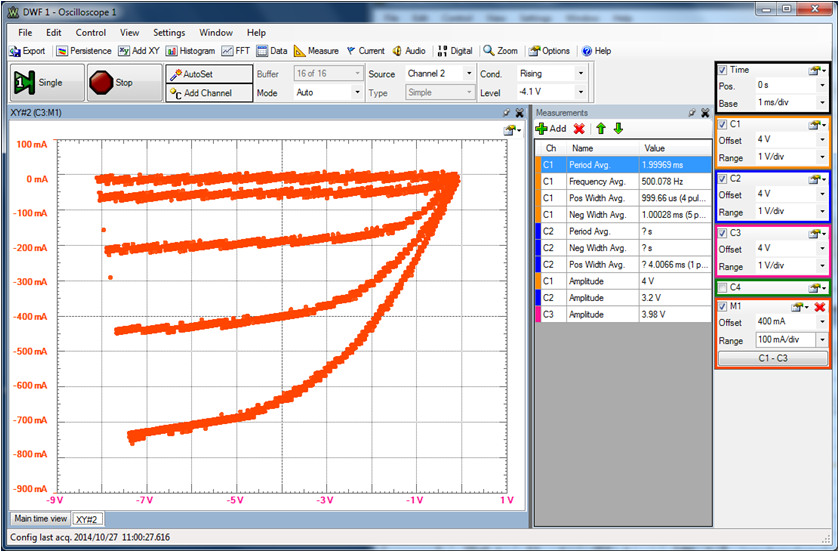 
|
MOSFET Parameterextraktion
|
\( I_{DS}= \cases{ 0 & \text{ f³r } U_{GS} \leq U_{th} \text{ Sperrbereich } \cr
\beta \left( U_{GS}-U_{th} \right)^2 \left( 1+\lambda U_{DS} \right)
& \text{ f³r } 0 \leq U_{GS} - U_{th} \lt U_{DS} \text{ Sõttigung } \cr
\beta \left( 2 \left( U_{GS}-U_{th} \right) U_{DS} - U_{DS}^2 \right)
& \text{ f³r } 0\leq U_{GS} - U_{th} \geq U_{DS} \text{ Triodenbereich }
}
\) \( \beta = \frac{\mu_{n} \epsilon_{ox}}{2d_{ox}} \frac{W}{L} = \frac{1}{2} \mu_{n} C_{ox}^{'} \frac{W}{L} = \frac{1}{2} K_{n}^{'} \frac{W}{L} = \frac{1}{2} K_{n} \) |
\( U_{GS} = const \); \( U_{DS1}, U_{DS2} \rightarrow \frac{I_{DS1}}{I_{DS2}} \rightarrow \lambda \)
\( U_{DS} = const \); \( U_{GS1}, U_{GS2} \rightarrow \frac{I_{DS1}}{I_{DS2}} \rightarrow U_{th} \)
\( \beta \)
Funktion:
\( y = \sqrt{I_{DS}} = \sqrt{\beta} \left( U_{GS} - U_{th} \right) \sqrt{\left( 1 + \lambda U_{DS} \right)} \)
\( y = \sqrt{\beta \left( 1 + \lambda U_{DS} \right)} U_{GS} - \sqrt{\beta \left( 1 + \lambda U_{DS} \right)} U_{th} \)
\( x = U_{GS} \), \( a = \sqrt{\beta \left( 1 + \lambda U_{DS} \right) } \) , \( b = - \sqrt{\beta \left( 1 + \lambda U_{DS} \right)} U_{th} = - a \cdot U_{th} \)
\( y = ax + b \)
1. Mathematische Methode:
Bei 2 Messungen bei gleicher Spannung UGS und unterschiedlicher Spannnung UDS im Sõttigungsbereich erhõlt man aus dem Verhõltnis der Str÷me λ.
Bei 2 Messungen bei gleicher Spannung UDS und unterschiedlicher Spannnung UGS im Sõttigungsbereich erhõlt man aus dem Verhõltnis der Str÷me Uth.
β kann man dann aus einer Messung durch einsetzen von IDS, Uth, λ und UGS berechnen.
2. Methode durch grafische Interpretation
Bei 2 Messungen bei gleicher Spannung UGS im Sõttigungsbereich erhõlt man aus dem Verhõltnis der Str÷me λ. Trõgt man die Wurzel des Stromes IDS ³ber der Gate-Source-Spannung auf ergibt sich eine Geradengleichung.
Aus der Steigung dieser Geraden und dem y-Achsenabschnitt bei x = UGS0 ergeben sich Uth und bei kleinem λ und Vernachlõssigung von λ UDS gegen³ber 1 dann β.
Bei 2 Messungen bei gleicher Spannung UGS und unterschiedlicher Spannnung UDS im Sõttigungsbereich erhõlt man aus dem Verhõltnis der Str÷me λ.
Bei 2 Messungen bei gleicher Spannung UDS und unterschiedlicher Spannnung UGS im Sõttigungsbereich erhõlt man aus dem Verhõltnis der Str÷me Uth.
β kann man dann aus einer Messung durch einsetzen von IDS, Uth, λ und UGS berechnen.
2. Methode durch grafische Interpretation
Bei 2 Messungen bei gleicher Spannung UGS im Sõttigungsbereich erhõlt man aus dem Verhõltnis der Str÷me λ. Trõgt man die Wurzel des Stromes IDS ³ber der Gate-Source-Spannung auf ergibt sich eine Geradengleichung.
Aus der Steigung dieser Geraden und dem y-Achsenabschnitt bei x = UGS0 ergeben sich Uth und bei kleinem λ und Vernachlõssigung von λ UDS gegen³ber 1 dann β.
Junction Field-Effect Transistor JFET (SFET Sperrschicht FET)
|
Ausgangskennlinie ▄bertragungskennlinie |
- Much lower input current and much higher input impedance than the BJT.
- In triode region, JFET is a voltage-controlled resistor:
\( R_{CH} = \frac{\rho}{t} \frac{L}{W} \)
\( \rho \) = resistivity of channel
L = channel length
W = channel width between pn junction depletion regions
t = channel depth
Inherently a depletion-mode device
Fragen: MOSFET
- Wie sieht der Querschnitt eines MOSFETs aus?
- Welche Anschl³sse hat der MOSFET?
- Welche Typen von Feldeffekttransistoren gibt es?
- Geben Sie die statische Gleichung eines MOSFETs an?
- Wie kann man die Schwellspannung beeinflussen?
- Wie sieht das Kleinsignalersatzschaltbild aus?
Gleichungen
|
\( I_{DS}= \cases{ 0 & \text{ f³r } U_{GS} \leq U_{th} \text{ Sperrbereich } \cr
\beta \left( U_{GS}-U_{th} \right)^2 \left( 1+\lambda U_{DS} \right)
& \text{ f³r } 0 \leq U_{GS} - U_{th} \lt U_{DS} \text{ Sõttigung } \cr
\beta \left( 2 \left( U_{GS}-U_{th} \right) U_{DS} - U_{DS}^2 \right)
& \text{ f³r } 0\leq U_{GS} - U_{th} \geq U_{DS} \text{ Triodenbereich }
}
\) \( \beta = \frac{\mu_{n} \epsilon_{ox}}{2d_{ox}} \frac{W}{L} = \frac{1}{2} \mu_{n} C_{ox}^{'} \frac{W}{L} = \frac{1}{2} K_{n}^{'} \frac{W}{L} = \frac{1}{2} K_{n} \) |
| \( U_{th}= U_{th0} + \gamma \left( \sqrt{U_{SB}+2\phi_F}-\sqrt{2\phi_F}\right) \) | \( g_m = \frac{2 I_D}{U_{GS}-U_{th}} \) |
| \( g_d = \beta \left( U_{GS}-U_{th} \right)^2 \lambda = \frac{I_{DS}\lambda}{1+\lambda U_{DS}} \simeq I_{DS} \lambda \) | \( \omega_g = \frac{1}{RC} \) |
| Spannungsverstõrkung: | Transitfrequenz: vu=1 | ||
|
|
